Приближение высоких энергий
Во многих случаях диффузионное уравнение не применимо, поскольку невозможно полагать, что разные процессы независимы друг от друга (  ≠ 0). К этим процессам обычно относят процессы обработки поверхностей лазером (формирование отверстий, абляция оптических дисков, абляция глаза, МОС-гидридная и МЛЭ эпитаксия, все процессы, где осуществляется фазовый переход второго рода и т.д.). В общем случае, в таких задачах приходится решать сложную систему дифференциальных уравнений с усложненными граничными условиями. Это выходит за рамки нашего курса. Однако, для выяснения многих вопросов важных для конкретных разработок, можно ограничиться решением задачи в диффузионном приближении, как правило, для стационарных потоков времени в узких приграничных областях раздела фаз.
≠ 0). К этим процессам обычно относят процессы обработки поверхностей лазером (формирование отверстий, абляция оптических дисков, абляция глаза, МОС-гидридная и МЛЭ эпитаксия, все процессы, где осуществляется фазовый переход второго рода и т.д.). В общем случае, в таких задачах приходится решать сложную систему дифференциальных уравнений с усложненными граничными условиями. Это выходит за рамки нашего курса. Однако, для выяснения многих вопросов важных для конкретных разработок, можно ограничиться решением задачи в диффузионном приближении, как правило, для стационарных потоков времени в узких приграничных областях раздела фаз.
В общем случае, результаты задачи не дают даже качественного описания процесса. Но относительные характеристики различных процессов (мощность, интенсивность тепла, количество энергии и т.д.) хорошо коррелируют с экспериментальными данными. Во многих случаях по этим результатам можно определить границы, в которых происходят различные виды нарушений (например, случаи деформации отверстий при лазерной обработки, возникновение напряжений глаза в результате абляции).
Вследствие того, что экспериментальные входные параметры для таких задач, как правило, определяется трудом, или не определяются вовсе, решение в диффузионном приближении не понижает общей точности модели. Это является основной причиной использования диффузионного приближения при моделировании практически всех высокоэнергетических процессов.
Рассмотрим применение данного приближения на примере выращивания полупроводниковых структур методом МОС-гидридной эпитаксии.
Пример.
Над поверхностью подложки протекает поток газовой смеси, содержащей элементы 3 и 5 групп. Вдали от подложки смеси находятся в квазиравновесном состоянии, т.е. количество процессов диссоциации молекул на атомы и образования молекул из атомов одинаково. Подложки играет роль фактора, нарушающего это равновесие, вследствие чего над поверхностью подложки образуется переходной слой, в которой преобладают процессы диссоциации (см. рис.2.2). Атомы и молекулы диффундируют к подложке и осаждаются на ее поверхности, формирую слой полупроводникового материала.
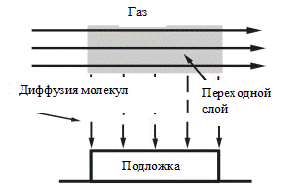 |
Рис.2.2 Схема роста при проведении процесса МОС-гидридного выращивания
В качестве источников элементов 3 группы (Ga, In, Al,Sb) используют металлоорганические соединения типа триметилгаллия Ga(C2H5)3, триметилалюминия Al(C2H5)3 или триметилиндия In(C2H5)3.
Источниками элементов 5 группы являются соединения водорода с мышьяком (арсин - AsH3) или с фосфором (фосфин - PH3).
Для легирования слоев используют соединения типа Zn(C2H5)2 триметил цинка (р-тип) или H2S (n-тип).
Рост ведется при давлениях газовой смеси 0,1 – 0,5 атм и температуре 500 – 600 0С. Скорость роста составляет 1 – 4 мкм/ч. Величина скорости роста лимитирована скоростью диффузии атомов из переходного слоя к поверхности подложки.
Основные проблемы связаны с конечной скоростью переключения газовых потоков, что определяет размытость границы (интерфейса) между слоями на величину ~ 1 нм.
Этот метод в настоящее время широко используется при промышленном производстве изделий оптоэлектроники, имеет высокую производительность и обеспечивает высокое качество гетероструктур.
Постановка задачи.
При соответствующих условиях осаждения атомы вышеперечисленных элементов, двигаясь по нагретой поверхности, занимают положения, соответствующие кристаллической структуре подложки. Иными словами эпитаксиальное наращивание состоит в образовании центров кристаллизации и последовательном формировании двумерной решетки из островков, растущих вдоль поверхности. Процесс эпитаксиального наращивания на поверхности пластины (см. рис. 2.3) происходит в следующей последовательности:
- массопередача вступающих в реакцию молекул посредством диффузии из турбулентного потока через граничный слой к поверхности;
- адсорбция молекул поверхностью;
- процесс реакции на поверхности;
- десорбция продуктов реакции;
- массопередача молекул продуктов реакции посредством диффузии через граничный слой к основному потоку газа;
- упорядочение адсорбированных атомов материала в решетке.
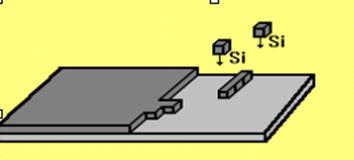
Рис. 2.3. Формирование слоя на подложке на примере кремния.
Результирующая скорость роста пленки определяется самым медленным процессом в приведенной выше последовательности. В равновесных условиях все процессы протекают с одинаковыми скоростями, и эпитаксиальный слой растет равномерно.
Попытка увеличения скорости роста пленки выше оптимального значения, зависящего от температуры, приводит к росту поликристаллической пленки (уменьшается время поверхностной миграции и происходит встраивание кремния в произвольные, а не только кристаллографически благоприятные места).
Задачей моделирования в данной определение зависимости выходной температуры процесса от скорости роста, при которой зародышевое образование приводит к росту поликристаллической пленки. В данной постановке задача представляет собой описание сильно неравновесного процесса, в котором связано два потока – скорости и температуря. Для приведения этой задачи к моделированию диффузионным приближением, необходимо:
1. Разделить потоки, т.е. связать входную скорость с входной температурой.
2. Ограничить область
В этом случае, задачу можно представить как моделирование зависимости выходного потока от входного, и предположить, что граничные условия определяются условиями механического равновесия [2].
Ограничим область нашего моделирования скоростями, где число Рейнольдса:
Re = D*v*ρ/η= 100 (2.42)
меньше критического значения:
Re крит. = 2000, (2.43)
где D - диаметр трубы реактора;
v - скорость течения газа;
ρ - плотность газа;
η - коэффициент вязкости газа.
В этом случае у поверхности раздела сред существует область, где тепловой поток описывается в приближении теплового импульса. Данный тепловой импульс можно взять в качестве граничных условий для решения задачи конвективного массопереноса с переменными коэффициентами.
В этом случае параметры системы предполагаются непрерывными вместе со своими производными.
Трехмерная задача распределения скоростей (температур) по реактору остается достаточно сложной, но, вследствие условия 2, ее можно представить в одномерном приближении в виде следующей упрощенной схемы (рис. 2.3):
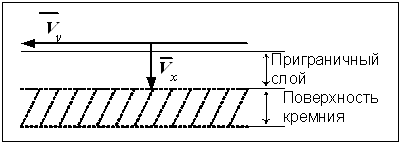
Рис. 2.3. Упрощенная схема процесса МОС-гидгидной эпитаксии
Vy - процесс прохождения потока
Vx - процесс осаждения.
Для уменьшения размерности можно ограничиться только исследованием скорости Vx.
Построение упрощенных граничных условий.
Поскольку мы ограничиваемся только исследованием температурных потоков, то необходимо определить связь между начальной скоростью газа и начальной температурой эпитаксии. Как показывают экспериментальные исследования, в этом случае Vx является линейной функцией температуры θ. Коэффициент пропорциональности можно определить экспериментально.
Граничными условиями является решение задачи Коши для уравнения теплопроводности в случае, если источником тепла является поверхностный тепловой потенциал.
Поверхностный тепловой потенциал.
Тепловой потенциал  с плотностью
с плотностью  называется поверхностным тепловым потенциалом (простого слоя с плотностью
называется поверхностным тепловым потенциалом (простого слоя с плотностью  ):
):
 (2.44)
(2.44)
Если  - ограниченная функция в
- ограниченная функция в  , то поверхностный тепловой потенциал
, то поверхностный тепловой потенциал  существует в
существует в  , принадлежит классу
, принадлежит классу  , представляется интегралом Пуассона:
, представляется интегралом Пуассона:
 (2.45)
(2.45)
Пусть  , где
, где  и
и  - ограниченная функция в
- ограниченная функция в  . В этом случае решение соответствующей обобщённой задачи Коши существует [2] и единственно в классе
. В этом случае решение соответствующей обобщённой задачи Коши существует [2] и единственно в классе  и представляется формулой Пуассона:
и представляется формулой Пуассона:
 (2.46)
(2.46)
при этом, u(x, t) – отношение реальной температуры начала процесса к максимально возможной.
Вычислим область, в которой данное приближенное решении будет работать.
 ,
,
обозначим  =const-любое число от 0 до 0,5;
=const-любое число от 0 до 0,5;
U0 – табличная функция Ф(х);
 - в данном случаи входная температура процесса.
- в данном случаи входная температура процесса.
При проведении вычислении используется пакет программ для решения одномерного уравнения теплопроводности с учётом конвективного переноса тепла в среде: «Тепло и массоперенос», в котором решается уравнение вида:
 , (2.47)
, (2.47)
где  - теплоёмкость (задание удельной теплоёмкости)
- теплоёмкость (задание удельной теплоёмкости)
 - теплопроводность
- теплопроводность
 - источник
- источник
 - коэффициент теплопроводности
- коэффициент теплопроводности
 - скорость переноса
- скорость переноса
Распределение граничных условий представлено на графике (рис. 2.4):

Рис. 2.4. График распределения граничных условий.
Остальные параметры выбираются из экспериментальных или литературных данных.
Пример результатов расчетов приведен на рисунке 2.5:

Рис. 2.5. Результаты расчетов.
Анализ результатов показывает, что температура в начале процесса остается постоянной. После какого-то момента времени t=t0 резко возрастает. В процессе эпитаксии это приведет к неравномерному росту кристаллов. В этом случае, процесс считается неудачным. По нижеприведенному графику температур, построенной по сводной таблице, температура после которой процесс можно считать неудачным, примерно равна 0,1 от максимально возможной температуры.
Таким образом, температура в приграничном слое необходимо поддерживать меньше значения, равного 0,1 максимально возможной температуры. В противном случае не будет выполняться условие равномерного выращивания кристаллов.
