Влияние барьерной емкости эмиттерного
Перехода
Барьерная емкость эмиттерного перехода обусловлена изменениями ширины перехода, т.е. перемещением основных носителей. Ток перезаряда этой емкости не имеет отношения к инжекции и не входит в состав коллекторного тока. Следовательно, та часть тока эмиттера, которая ответвляется в барьерную емкость (рис. 2.2,а), приводит к замедлению нарастания коэффициента инжекции. Это дополнительно (вместе с функцией  ) затягивает переходный процесс в транзисторе. Постоянную времени эмиттерного перехода
) затягивает переходный процесс в транзисторе. Постоянную времени эмиттерного перехода  называют также постоянной времени инжекции.
называют также постоянной времени инжекции.
Если  = 25 Ом и
= 25 Ом и  =1 пФ, то
=1 пФ, то  = 0,025 нс, т.е. обычно
= 0,025 нс, т.е. обычно
tбэ << tпр и постоянную времени  можно не учитывать или учитывать в виде дополнительной задержки. Однако с уменьшением тока
можно не учитывать или учитывать в виде дополнительной задержки. Однако с уменьшением тока  сопротивление
сопротивление  растет и величина
растет и величина  становится сравнимой с tпр. Поэтому в микротоковом режиме работы транзистора влияние инерционности эмиттерного перехода сводится к увеличению постоянной времени
становится сравнимой с tпр. Поэтому в микротоковом режиме работы транзистора влияние инерционности эмиттерного перехода сводится к увеличению постоянной времени 
ta » tбэ + tпр.
ПОЛЕВЫЕ ТРАНЗИСТОРЫ. ХАРАКТЕРИСТИКИ
И ЭКВИВАЛЕНТНАЯ СХЕМА
Работа полевых (униполярных) транзисторов основана на использовании основных носителей одного типа (электронов или дырок). Носители движутся за счет дрейфа в электрическом поле. Процессы инжекции и диффузии, присущие биполярным транзисторам, здесь практически отсутствуют. Управление током в полевых транзисторах (ПТ) осуществляется электрическим полем путем изменения удельной проводимости соответствующего слоя (канала) или его площади.
Полевые транзисторы структуры металл-диэлектрик-полупровод-ник (МДП) имеют приповерхностный канал либо встроенный, либо индуцированный (рис. 2.7). В первом случае обогащенный слой формируется за счет донорных примесей в диэлектрике, во втором – под действием электрического поля образуется инверсионный слой.
В МОП-транзисторах в качестве диэлектрика используется окисел (дву-окись кремния). Условное обозначение МДП-транзисторов со встроенным каналом p-типа показано на рис. 2.8,a, с индуцированным каналом n-типа – на рис. 2.8,б. Стрелка на выводе подложки показывает условное направление движения положительно заряженных носителей (дырок) относительно носителей канала: n-канал притягивает дырки
(рис. 2.8,а,б). Для транзистора с каналом р-типа направление стрелки
и полярность источников питания меняются на обратные.
Наличие тонкого слоя диэлектрика под затвором снимает ограничение на полярность смещения Uзи: она может быть как положительной, так и отрицательной, так как в обоих случаях ток затвора отсутствует.
При наличии встроенного (собственного) канала его проводимость мо-дулируется смещением на затворе. В случае канала n-типа (рис. 2.7,а) отрицательный потенциал  отталкивает электроны из канала (режим обеднения), а положительный – притягивает их (режим обогащения). Соответственно проводимость канала либо уменьшается, либо увеличивается по сравнению с ее значением при нулевом смещении.
отталкивает электроны из канала (режим обеднения), а положительный – притягивает их (режим обогащения). Соответственно проводимость канала либо уменьшается, либо увеличивается по сравнению с ее значением при нулевом смещении.
Вторая структура МДП-транзисторов (рис. 2.7,б) не имеет специально устроенного канала. Поэтому при нулевом смещении на затворе проводимость между истоком и стоком отсутствует: исток и сток образуют с подложкой встречно включенные р-n переходы. Тем более не может быть проводимости между истоком и стоком при отрицательной полярности смещения, когда к поверхности полупроводника притягиваются дополнительные дырки. Лишь при достаточно большом поло-жительном смещении, когда приповерхностный слой сильно обогащается притянутыми электронами, между истоком и стоком образуется своего рода индуцированный (наведенный полем) канал, по которому может протекать ток. Простота изготовления транзисторов с индуцированным каналом привела к их широкому применению.
На рис. 2.9,а показаны вольт-амперные характеристики МДП-тран-зистора со встроенным n-каналом при нулевом напряжении Епи, т.е. когда вывод подложки соединен с истоком. В соответствии с семейством ВАХ транзистор закрывается при отрицательном напряжении затвор-исток: Uотс < 0. Насыщение транзистора достигается при положительном напряжении Uзи. Встроенный канал n-типа имеют, например, транзисторы КП 305.
Потенциал подложки в принципе может использоваться для управления током канала. Так положительное напряжение Епи будет дополнительно обеднять канал (рис. 2.7,а), уменьшая ток стока. Однако крутизна управления по подложке

обычно меньше крутизны по затвору
 .
.
Кроме того, входное сопротивление по подложке Rвх пи определяется обратными токами p-n переходов и уступает входному сопротивлению по затвору в  раз.
раз.
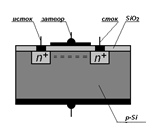
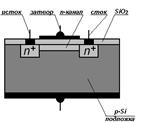
| |||||||
| |||||||
| |||||||
|
|
а
|
|
|
|
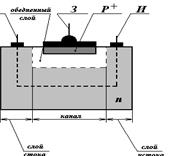
в
Рис. 2.7
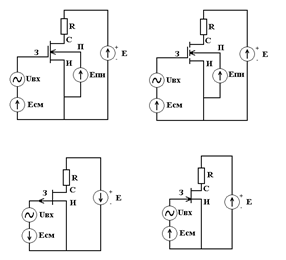
| |
|
|
|
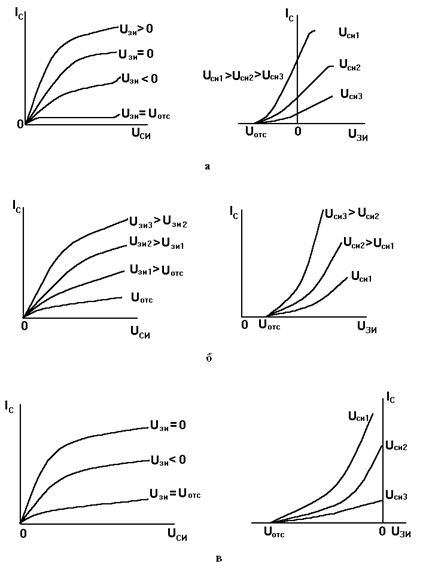
Рис. 2.9
| |
МДП-транзистор с индуцированным каналом является нормально закрытым: при Uзи проводимость канала и ток стока практически отсутствуют. ВАХ такого транзистора изображена на рис. 2.9,б. В этом случае положительное напряжение отсечки может составлять доли еди-ницы вольта. Примером МДП-транзистора с индуцированным каналом является прибор КП 301.
Эквивалентная схема МДП-транзисторов для переменных составляющих с учетом влияния подложки показана на рис. 2.10,а. Сопротивление канала обозначено rси, усилительные свойства транзистора отображены источниками тока с учетом крутизны по затвору S и по под-ложке Sп. Сопротивления rзс и rзи намного больше, чем rпи и rпс, что объясняется наличием диэлектрика между затвором и каналом. Поэтому элементы rзс, rзи можно не учитывать. Межэлектродные емкости Сзс, Сзи обусловлены частичным перекрытием металлического электрода затвора с областями истока и стока в реальных структурах. Как правило, емкости Сзс, Сзи меньше барьерных областей истокового и стокового переходов Спи, Спс. Очевидно, что емкость Сзс является элементом внутренней обратной связи и ее желательно минимизировать. Емкость между слоями истока и стока для МДП-транзистора давольно мала, и ею можно пренебречь. Для маломощных МДП-транзисторов обратные сопротивления переходов rпи, rпс составляют 1010¸1011 Ом.
Емкости Спи, Спс определяются площадями истока и стока
и имеют значение 0,1¸0,5 пФ. Крутизна S обычно составляет 1¸5 мА/B.
Увеличить усиление можно было бы, соединив подложку с затвором, когда результирующая крутизна равна Sп + S. Однако в этом случае резко снижается входное сопротивление транзистора.
Чаще всего на практике электрод подложки находится либо внутри корпуса транзистора, либо не используется в схеме устройства. При этом эквивалентная схема с учетом вышесказанного упрощается, как показано на рис. 2.10,б.
Полевые транзисторы второго вида используют объемный канал, представлявщий собой участок однородного полупроводника, отделенный от поверхности обедненным слоем. Обедненный слой создается с помощью p-n перехода (рис. 2.7,в). Роль затвора выполняет металлический контакт вместе со слоем  хотя последний необязателен
хотя последний необязателен
и отсутствует в транзисторах с барьером Шоттки (с контактом металл– полупроводник).
|
|
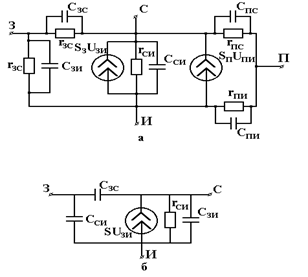
Рис. 2.10
Прямое смещение p-n-перехода не используется, так как транзистор перестанет быть униполярным – начнется инжекция неосновных носителей. Обратное напряжение смещения на затворе определяет глубину обедненного слоя L (рис. 2.7,в). Чем глубже обедненный слой, тем меньше толщина канала w и соответственно больше сопротивление канала. Таким образом, полевой транзистор с p-n-переходом в качестве затвора является нормально открытым прибором при нулевом напря-
жении смещения. Ток стока уменьшается с увеличением (по модулю) обратного напряжения Uзи и при напряжении отсечки
 В
В
полевой транзистор оказывается в закрытом состоянии. Для практической реализации приемлемого значения  толщина рабочего слоя и концентрация примеси в нем должны быть достаточно малы. При нулевом напряжении на затворе относительно истока сопротивление канала rси составляет сотни Ом, а при
толщина рабочего слоя и концентрация примеси в нем должны быть достаточно малы. При нулевом напряжении на затворе относительно истока сопротивление канала rси составляет сотни Ом, а при  сопротивле-
сопротивле-
ние rси возрастает до 1,5¸2 кОм.
С учетом сказанного, семейство строковых ВАХ полевых транзисторов с объемным каналом (рис. 2.9,в) имеет сходство с аналогичным семейством для МДП-транзисторов со встроенным каналом (рис. 2.9,а), однако первые работают только при одной (обратной) полярности напряжения на затворе в режиме обеднения канала. Передаточные характеристики поэтому расположены только в области Uзи £ 0 (рис. 2.9,в).
Важнейшим преимуществом полевых транзисторов с p-n-перехо-дом является очень малый уровень собственных шумов, включая диапазон низких частот. Это обусловлено отсутствием инжекции соответствующих флуктуаций тока. Кроме того, канал граничит с обедненным слоем, т.е. отсутствуют поверхностные дефекты и загрязнения – причина шумов МДП-транзистора. Тепловые же шумы, обусловленные сопротивлением канала rси, составляют, например, 5¸20 нВ на частоте
10 Гц в полосе 1 Гц при крутизне 3¸5 мА/В. Входное сопротивление, определяемое током термогенерации обратно смещенного перехода, достигает величин 109¸1010 Ом, что сравнимо с входным сопротивлением электронных ламп. Типичными представителями указанных ПТ являются приборы КП303, КП307.
Эквивалентная схема ПТ с объемным каналом, как и электронной лампы, может быть упрощена до схемы рис.2.10,б, где емкость Спи следует заменить емкостью Сси (для лампы – соответственно Сак).
Инерционность полевых транзисторов отражается как емкостями эквивалентной схемы, так и зависимостью комплексной крутизны от частоты
 ,
,
где  – постоянная времени крутизны, равная произведению средних значений сопротивления канала и емкости затвор-канал (сечения канала и обедненного слоя на разных участках различны).
– постоянная времени крутизны, равная произведению средних значений сопротивления канала и емкости затвор-канал (сечения канала и обедненного слоя на разных участках различны).
