Резонансное туннелирование
Когда область, в которую или из которой может происходить туннельный переход электрона, является квантово-размерной (квантовая плоскость, квантовая линия, квантовая точка), то наблюдается еще один интересный эффект – "резонансное туннелирование". Чтобы объяснить его физическую сущность, рассмотрим снова двойной туннельный барьер (ДТБ), в котором промежуточный слой между двумя туннельными переходами является квантовой плоскостью. На рис. 3.8 слева показаны соответствующие энергетические диаграммы. Вдоль вертикали отложена энергия электронов, вдоль горизонтали – координата. Цифрами 1 и 5 на последней обозначены внешние области, к которым прикладывается напряжение: 1 – катод, 5 – анод;  и
и  – энергетические уровни Ферми в них. Цифрами 2 и 4 обозначены туннельные барьеры, цифрой 3 – квантово-размерная область.
– энергетические уровни Ферми в них. Цифрами 2 и 4 обозначены туннельные барьеры, цифрой 3 – квантово-размерная область.
Как мы уже отмечали выше, в такой области значения энергии электрона квантованы. Через  и
и  обозначены разрешенные в этой области энергетические уровни. В диапазоне энергий, который здесь рассматривается, в этих областях нет разрешенных энергетических уровней для электронов.
обозначены разрешенные в этой области энергетические уровни. В диапазоне энергий, который здесь рассматривается, в этих областях нет разрешенных энергетических уровней для электронов.
Обозначим разности между разрешенными в квантово-размерной области энергетическими уровнями  и
и  и энергетическим уровнем Ферми
и энергетическим уровнем Ферми  через
через
 | ( 3.26) |

Рис. 3.8.
Напомним, что при туннельном переходе энергия электрона не изменяется. Примем во внимание также то, что электрическое напряжение  , приложенное между анодом и катодом, падает в основном на туннельных барьерах 2 и 4 и распределяется между ними примерно поровну. Потенциальная энергия электронов в области анода 5 уменьшается на величину
, приложенное между анодом и катодом, падает в основном на туннельных барьерах 2 и 4 и распределяется между ними примерно поровну. Потенциальная энергия электронов в области анода 5 уменьшается на величину  , вследствие чего все энергетические уровни смещаются вниз. В квантово-размерной области 3 потенциальная энергия электронов уменьшается на величину
, вследствие чего все энергетические уровни смещаются вниз. В квантово-размерной области 3 потенциальная энергия электронов уменьшается на величину  , и на такую же величину смещаются вниз разрешенные энергетические уровни
, и на такую же величину смещаются вниз разрешенные энергетические уровни  и
и  .
.
Верхняя энергетическая диаграмма ( рис. 3.8.а) соответствует случаю, когда  . Для большинства электронов из области 1, которые находятся вблизи уровня Ферми
. Для большинства электронов из области 1, которые находятся вблизи уровня Ферми  , в области 3 не находится разрешенного энергетического уровня. И потому их туннельный переход сквозь барьер 2 не происходит. Пройти сквозь этот барьер из области 1 могут лишь электроны с энергией на
, в области 3 не находится разрешенного энергетического уровня. И потому их туннельный переход сквозь барьер 2 не происходит. Пройти сквозь этот барьер из области 1 могут лишь электроны с энергией на  выше уровня Ферми, а таких электронов мало. Туннельный ток незначителен.
выше уровня Ферми, а таких электронов мало. Туннельный ток незначителен.
Когда же напряжение между анодом 5 и катодом 1 возрастает до величины, при которой  , тогда уже значительная часть электронов с энергиями близ уровня Ферми
, тогда уже значительная часть электронов с энергиями близ уровня Ферми  имеет возможность пройти сквозь туннельный барьер 2. И электрический ток сквозь структуру резко возрастает, достигая максимума при
имеет возможность пройти сквозь туннельный барьер 2. И электрический ток сквозь структуру резко возрастает, достигая максимума при  . Типичная вольтамперная характеристика структуры показана на рис. 3.8.г. Когда напряжение превышает указанную величину, то для большинства электронов из области 1 снова не находится разрешенного энергетического уровня в области 3, и они не могут пройти в эту область. Туннельный ток сквозь структуру уменьшается ( рис. 3.8.в). И лишь когда напряжение начинает приближаться к величине
. Типичная вольтамперная характеристика структуры показана на рис. 3.8.г. Когда напряжение превышает указанную величину, то для большинства электронов из области 1 снова не находится разрешенного энергетического уровня в области 3, и они не могут пройти в эту область. Туннельный ток сквозь структуру уменьшается ( рис. 3.8.в). И лишь когда напряжение начинает приближаться к величине  , у некоторых электронов из области 1 появляется возможность перейти на разрешенный энергетический уровень
, у некоторых электронов из области 1 появляется возможность перейти на разрешенный энергетический уровень  . И тогда туннельный ток сквозь структуру снова начинает расти.
. И тогда туннельный ток сквозь структуру снова начинает расти.
Описанное явление резкого возрастания электрического тока сквозь туннельный переход, когда энергетические уровни электронов с обеих сторон от перехода уравниваются, называют "резонансным туннелированием" (англ. resonant tunneling).
Как видно из рис. 3.8.г, вольтамперная характеристика ДТБ является ВАХ N-типа и имеет значительный участок с отрицательным дифференциальным сопротивлением. Благодаря этому на основе таких структур можно строить перспективные электронные схемы.
Выше мы уже писали, что время перехода электрона сквозь отдельный туннельный барьер очень мало (~10-15 с). При переходе сквозь двойной туннельный барьер к этому короткому времени прибавляется еще сравнительно значительное время пребывания электрона в промежуточной квантово-размерной области 3. Для двойной гетероструктуры, изображенной на рис. 3.9 слева, время перехода составляет, например, ~10-11 с.
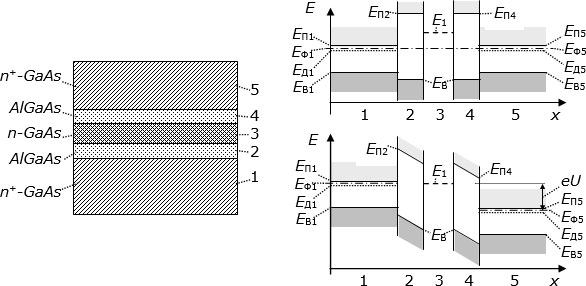
Рис. 3.9.Слева – структура ДТБ с квантово-размерной центральной областью, полученная методом МЛЭ. Справа – энергетические диаграммы такой структуры: вверху – при отсутствии, внизу – при наличии приложенного напряжения
Эта гетероструктура, полученная методом молекулярно-лучевой эпитаксии (МЛЭ), состоит из 5 монокристаллических слоев: 1 и 5 (катод и анод соответственно) – это высоколегированный арсенид галлия  ; 2 и 4 (туннельные барьеры) – значительно более широкозонные высокоомные слои
; 2 и 4 (туннельные барьеры) – значительно более широкозонные высокоомные слои  толщиной примерно 5 нм; 3 (квантово-размерная область) – низколегированный арсенид галлия
толщиной примерно 5 нм; 3 (квантово-размерная область) – низколегированный арсенид галлия  толщиной 5-7 нм. Справа показаны соответствующие энергетические диаграммы. Вдоль вертикали отложена энергия электронов, вдоль горизонтали – координата и указаны номера областей. На этих диаграммах обозначения
толщиной 5-7 нм. Справа показаны соответствующие энергетические диаграммы. Вдоль вертикали отложена энергия электронов, вдоль горизонтали – координата и указаны номера областей. На этих диаграммах обозначения  – это верхняя граница ("потолок") валентных зон полупроводника в областях 1, 2(4) и 5 соответственно;
– это верхняя граница ("потолок") валентных зон полупроводника в областях 1, 2(4) и 5 соответственно;  и
и  – энергетические уровни примесей в областях 1 и 5;
– энергетические уровни примесей в областях 1 и 5;  и
и  – энергетические уровни Ферми в областях 1 и 5;
– энергетические уровни Ферми в областях 1 и 5;  – нижняя граница ("дно") зон проводимости полупроводника в областях 1, 2, 4 и 5 соответственно;
– нижняя граница ("дно") зон проводимости полупроводника в областях 1, 2, 4 и 5 соответственно;  – разрешенный энергетический уровень в квантово-размерной области 3.
– разрешенный энергетический уровень в квантово-размерной области 3.
Когда напряжение между катодом и анодом отсутствует, уровни энергии Ферми во всех зонах одинаковы (диаграмма справа вверху). Высота туннельных барьеров составляет более 0,2 эВ, что при комнатных температурах непреодолимо для электронов проводимости.
Диаграмма внизу показана для случая, когда напряжение на структуре  , и сквозь структуру течет максимальный туннельный ток.
, и сквозь структуру течет максимальный туннельный ток.
Добавление управляющего электрода к резонансно-туннельному диоду превращает последний в резонансно-туннельный транзистор (resonant tunneling transistor)и расширяет возможности его применения. Условное обозначение резонансно-туннельного транзистора в электрических схемах и его вольтамперная характеристика изображены на рис. 3.38. Потенциал, подаваемый на дополнительный электрод, смещает вольтамперную характеристику диода вдоль оси тока. Возможна также комбинация резонансно-туннельного диода с обычным транзистором. Этот вариант использован для создания резонансно-туннельного биполярного транзистора (resonant tunneling Ьipolar transistor) и резонансно-туннельного транзистора на горячих электронах (resonant tunneling hot electron transistor. Такие приборы имеют отрицательную крутизну вольтамперной характеристики в схеме включения с заземленным эмиттером. Кроме перечисленных приборов существуют также транзисторные структуры, представляющие собой управляемые затвором резонансно-туннельные диоды (gated resonant tunneling diodes). С целью управления условиями резонанса тока затворы в них изготавливают в виде барьеров Шоттки или р-п-переходов вокруг эмиттера. На рис. 3.39 показан пример такого прибора. В нем область эмиттера (а следовательно, и эмиттерный ток) можно модулировать с помощью потенциала на затворе, выполненного в виде окружающего эмиттер р-п-перехода. Такое управление эмиттерным током позволяет управлять максимальным током, протекающим через структуру в резонансных условиях.
 Рис. 3.38.Условное обозначение резонансно-туннельноrо транзистора в электрических схемах и его вольтамперные характеристики
Рис. 3.38.Условное обозначение резонансно-туннельноrо транзистора в электрических схемах и его вольтамперные характеристики
СПИН-ЗАВИСИМЫЙ ТРАНСПОРТ НОСИТЕЛЕЙ ЗАРЯДА Изучением специфических явлений, связанные со спин-зависимым транспортом носителей заряда в твердотельных структурах, и разработкой электронных приборов на их основе занимается новое направление науки и техники - спинтроника (spintronics), названное так, поскольку именно спин электрона (наравне с его зарядом) используется для электронной обработки информации. Как самостоятельное направление научных исследований и инженерных разработок спинтроника сформировалась только в конце ХХ века в результате накопления фундаментальных знаний и изготовления первых электронных приборов со спин-зависимым транспортом носителей заряда методами обычной микроэлектронной технологии и быстро развивающейся нанотехнологии. Интерес к спинтронным электронным приборам обусловлен двумя обстоятельствами. Во-первых, ожидается, что характеристики таких приборов будут значительно лучше, чем у их полупроводниковых аналогов. Во-вторых, спинтронные приборы могут обеспечить элементную базу для реализации квантовых вычислений и основанных на них квантовых компьютеров. При этом они потребляют значительно меньшую мощность за счет того, что для переключения спина требуется гораздо меньшая энергия, чем для переноса заряда. Устройства спинтроники обладают высоким быстродействием, поскольку в них для переключения из одного состояния в другое достаточно лишь развернуть спин в обратном направлении, а не перемещать в пространстве заряд и связанную с ним массу, как в полупроводниковых структурах. Учитывая тот факт, что в природе возможны лишь две противоположные ориентации спинов носителей заряда (их условно обозначают как «спин-вниз» и «спин-вверх») определенная ориентация спина носителя заряда может быть использована в качестве одного бита информации. Спиновые эффекты проявляются как в индивидуальном, так и в коллективном поведении носителей заряда в транспортных процессах в микроэлектронных и наноэлектронных структурах, помещенных в магнитное поле. Их главной характеристикой является магниmосопроmивление (magnetoresistance)- относительное изменение электрического сопротивления материала или структуры в магнитном поле. Количественно величина магнитосопротивления определяется как выраженное в процентах отношение ΔR/Rо , где ΔR = Rн - Rо; ΔR - изменение сопротивления в магнитном поле; Rо, Rн - сопротивление при нулевом и рабочем магнитном поле соответственно. Магнитосопротивление характеризует спиновые эффекты при диффузионном и баллистическом транспорте носителей заряда, а также при туннелировании. Положительное значение магнитосопротивления соответствует росту сопротивления в магнитном поле. В отсутствии магнитного поля носители заряда движутся прямолинейно· между двумя столкновениями (актами рассеяния), а в магнитном поле, приложенном перпендикулярно направлению электрического поля, их траектории приобретают форму циклоиды. Проходя то же расстояние между двумя столкновениями по циклоиде, они проходят меньшее расстояние в линейном направлении. В идеальном случае положительное магнитосопротивление должно возрастать пропорционально Н2 . Отклонение от этой зависимости в наноструктурах связано с заметным спин-зависимым рассеянием носителей заряда. В объемных материалах и в наноструктурах имеет место и отрицательное магнитосопротивление, т. е. уменьшение сопротивления в магнитном поле. Природа отрицательного магнитосопротивления различна: спин-зависимое рассеяние носителей заряда на примесях и кластерах дефектов, дипольное взаимодействие с этими дефектами, прыжковый перенос носителей заряда. Доминирующую роль в переносе носителей может играть прыжковая проводимость за счет локализованных на магнитных примесях носителей.
Спин-зависимый транспорт носителей заряда. В экспериментах по измерению магнитосопротивления часто наблюдается его знакопеременное поведение - в слабых магнитных полях отрицательное магнитосопротивление, а при увеличении напряженности магнитного поля - положительное. В реальных образцах знак и величина магнитосопротивления определяются суперпозицией названных явлений. Другим важным аспектом коллективного проявления спиновых эффектов в твердых телах является магнитооптическое взаимодействие, наиболее проявляющееся в магнитных полупроводниках. Этой группе материалов наряду с типичными полупроводниковыми свойствами присущи и магнитные свойства, определяемые преимущественной ориентацией спинов носителей заряда. Примером таких материалов могут служить так называемые разбавленные магнитные полупроводники, представляющие собой классические полупроводники - GaAs, Si и др., в состав которых в значительных концентрациях введены атомы магнитных элементов, чаще всего марганца. Поглощение такими полупроводниками света зависит от его оптической поляризации. Соответственно и излучают они свет с определенной поляризацией, что находит применение для квантового кодирования и декодирования оптически передаваемой информации.
Гигантское магнитосопротивление Многослойные тонкопленочные структуры из чередующихся слоев немагнитного и магнитного материалов демонстрируют значительное изменение сопротивления в магнитном поле. Это явление называют эффектом гигантского магнитосопротивления (giant magnetoresistance effect). За его открытие А. Ферт и П. Грюнберг в 2008 г. были удостоены Нобелевской премии по физике. Эффект наблюдается, когда электрический ток пропускают как в плоскости слоев, так и перпендикулярно им.
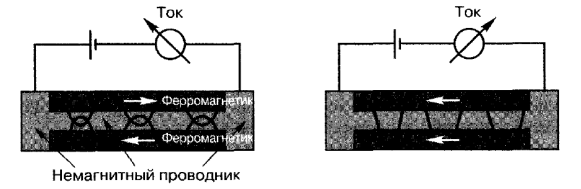
Рис. 3.41.Эффект гигантского магнитосопротивления в тонкопленочной структуре с параллельным плоскости слоев протеканием тока: а - антипараллельная намагниченность ферромагнитных слоев обусловливает высокое сопротивление; б - параллельная намагниченность ферромагнитных слоев - низкое сопротивление
Эти две основные конфигурации называются конфигурациями с протеканием тока в плоскости (current-in-plane, CIP) и с протеканием тока перпендикулярно ей ( current-perpendicular-to-plane, СРР). Тонкопленочная структура с параллельным плоскости слоев протеканием тока схематически показана на рис. 3.41. Ферромагнитные слои с противоположной намагниченностью могут быть получены пугем осаждения в соответствующих по ориентации магнитных полях. В отсутствие магнитного поля сопротивление максимально при противоположном направлении магнитных моментов соседних ферромагнитных слоев. При этом электроны со спином, направленным вдоль вектора намагниченности одного слоя, не могут перемещаться по материалу с противоположной намагниченностью, поскольку в нем нет доступных для них энергетических состояний. Это приводит к отражению электронов от границ таких слоев и отсутствию в них тока. Сопротивление структуры минимально, когда магнитные моменты слоев ориентированы по направлению внешнего магнитного поля. Магнитное поле, необходимое для параллельной ориентации всех слоев, обычно называется полем насыщения. При низких температурах уменьшение сопротивления может достигать нескольких сотен процентов. Наиболее ярко этот эффект проявляется в многослойных структурах Fe/Cr и Со/Сu. Он усиливается с ростом числа слоев и достигает своего максимума для 100 слоев (при толщине каждого слоя в несколько нанометров). Взаимная ориентация магнитных моментов двух соседних магнитных слоев зависит от толщины разделяющего их промежуточного немагнитного слоя, изменяясь от параллельной как в ферромагнетике до антипараллельной как в антиферромагнетике. Это явление называют осциллирующим обменным взаимодействием (oscillatory exchange coupling). Оно приводит к периодическому изменению магнитосопротивления при изменении толщины немагнитного слоя. Эффект гигантского магнитосопротивления имеет место только при таких значениях толщины немагнитного слоя, для которых осуществляемая через него обменная связь достаточна для антипараллельной ориентации магнитных моментов магнитных слоев. С ростом напряженности магнитного поля магнитосопротивление постепенно уменьшается. Это связано с тем, что внешнее магнитное поле, ориентируя магнитные моменты магнитных слоев в одном направлении, должно преодолеть обменную связь, которая стремится ориентировать их антипараллельно (при данной толщине немагнитного слоя). Полная ориентация магнитных моментов в одном направлении достигается только в таком поле насыщения, величина которого близка к полю обменной связи.
Магнитосопротивление структур с перпендикулярным плоскости структуры протеканием тока обычно больше, чем в структурах с протеканием тока параллельно ее плоскости. Это связано с отсутствием шунтирующего тока, проходящего по разделяющим ферромагнитные слои промежуточным немагнитным слоям и по их граниuам. В этом случае при пересечении каждой граниuы раздела многослойной структуры все носители испытывают спин-зависимое рассеяние. Однако низкое сопротивление полностью металлических структур требует применения методов нанолитографии для изготовления вертикальных элементов с очень малым поперечным сечением, чтобы получить достаточное для практической регистрации изменение сопротивления. Особенности транспортных проuессов при протекании тока перпендикулярно плоскости структуры ферромагнетик/немагнитный проводн»к/ферромагнетик проиллюстр»рованы на рис. 3.42. Ток, возникающий в структуре под действием напряжения, имеет две составляющие, соответствующие электронам со спином вверх и со спином вниз. В отсутствие рассеяния по спину их смешивания не происходит. В ферромагнетиках в отличие от немагнитных материалов энергетические спектры для электронов со спином вниз и со спином вверх различны (это показано на рисунке). Электроны с областью разрешенных состояний выше уровня Ферми участвуют в транспортных проuессах в качестве свободных носителей заряда. Разрешенные состояния электронов с противоположной ориентацией спина лежат ниже уровня Ферми, что исключает для них возможность свободно перемещаться в ферромагнетике. Переходя из одного ферромагнетика в другой, электроны занимают вакантные места только со своей спиновой поляризацией. Энергетический спектр спин-поляризованных электронов в ферромагнетиках описывается параболой для каждой спиновой составляющей. Разность между дном зоны «СПИН-вверх» и дном зоны «СПИН-ВНИЗ» поляризованных электронов отражает степень спиновой поляризации электронов в материале и количественно описывается характеристикой молекулярного поля ho. Когда намагниченности двух ферромагнетиков направлены противоположно друг другу (антипараллельны), то выходящие из одного ферромагнетика спин-поляризованные носители не могут попасть в другой ферромагнетик, не найдя соответствующих их спину вакантных мест в нем. Они рассеиваются на границе раздела, вызывая рост сопротивления. Напротив, одинаковое направление намагниченностей обоих ферромагнетиков гарантирует одинаковую поляризацию спинов инжектируемых электронов и электронных состояний в соседнем ферромагнитном слое. Таким образом, рассеяние носителей на границах раздела сводится к минимуму, что соответствует самому низкому сопротивлению структуры. Толщину слоев выбирают, как правило, исходя из требования, чтобы в каждом слое расстояние, на котором электрон сохраняет определенную ориентацию своего спина, было намного больше толщины этого слоя. Такое условие обычно хорошо выполняется при толщине слоя менее 10 нм. Электрон должен иметь возможность пройти через большое число слоев, прежде чем ориентация его спина изменится. На всем пути следования электрона каждая магнитная граница раздела может играть для его спина роль своеобразного фильтра. Чем больше рассеивающих границ раздела пересекает электрон, тем сильнее эффект «фильтрования ». Это и объясняет увеличение гигантского магнитосопротивления с ростом числа слоев. Спин-зависимое рассеяние электронов на границе раздела обусловлено также рассогласованием периодов кристаллических решеток контактирующих материалов. Кроме того, оно зависит от степени согласования уровней Ферми и спиновых подзон на этих границах.
Тонкопленочная структура, состоящая из двух магнитных слоев, обычно рассматривается как спиновый вентиль (spin valve).Он конструируется так, чтобы магнитный момент одного из этих слоев был устойчив к изменению направления внешнего магнитного поля, а магнитный момент другого слоя при таких же условиях легко изменял свое направление на противоположное. Этот магнитомягкий слой действует, таким образом, как клапан, чувствительный к внешнему магнитному полю. Спиновые вентили, изготовленные методами обычной микроэлектронной технологии, применяются для контроля магнитных полей, магнитной записи информации и других приложений. Метод, наиболее часто используемый для антипараллельной ориентации магнитных моментов двух магнитных пленок в структуре спинового вентиля, заключается в последовательном осаждении двух ферромагнитных материалов, по-разному реагирующих на магнитные поля (например, кобальт и пермаллой Ni80Fe20). Коэрцитивная сила у пермаллоя меньше, чем у кобальта. 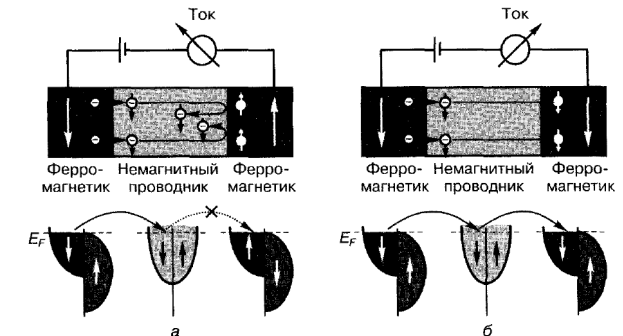 Рис. 3.42.Спин-поляризованный транспорт электронов через слоистую структуру ферромагнетик/немагнитный проводник/ферромагнетик: а - антипараллельная намагниченность ферромагнитных слоев (косвенная АФМ связь) - высокое сопротивление; б - параллельная намагниченность ферромагнитных слоев (ФМ обменная связь - низкое сопротивление
Рис. 3.42.Спин-поляризованный транспорт электронов через слоистую структуру ферромагнетик/немагнитный проводник/ферромагнетик: а - антипараллельная намагниченность ферромагнитных слоев (косвенная АФМ связь) - высокое сопротивление; б - параллельная намагниченность ферромагнитных слоев (ФМ обменная связь - низкое сопротивление
Изменения магнитной структуры, вызванные АФМ связью, влияют не только на магниторезистивные, но и на магнитные свойства многослойных наноструктур. В настоящее время мало изучены механизмы влияния косвенной обменной связи на магнитную анизотропию и доменную структуру в многослойных пленках. На примере многослойных пленок Со/Cu/Со было показано, что в металлических пленочных наноструктурах с косвенной АФМ связью индуцируется многоосная анизотропия. Более того, представленные на рис.5.2 трансформации доменной структуры (уменьшение размеров доменов до ~ 0,43 мкм) в образцах свидетельствуют о возможности применения этих пленок в качестве сред для магнитной записи информации. Это позволит не только значительно увеличить плотность записи информации, но и повысить термостабильность магнитных носителей.

Рис. 5.2.Электронно-микроскопические изображения доменной структуры пленки Со/Сu/Со с косвенной АФМ (а) и ФМ (б) обменной связью
Магнитный гистерезис наблюдается в магнитоупорядоченных веществах (в определенном интервале температур), например в ферромагнетиках, обычно разбитых на домены - области спонтанной (самопроизвольной) намагниченности, у которых величина намагниченности (магнитный момент единицы объема) одинакова, но направления различны. Под действием внешнего магнитного поля число и размеры доменов, намагниченных по полю, увеличиваются за счет других доменов. Векторы намагниченности отдельных доменов могут поворачиваться по полю. В достаточно сильном магнитном поле ферромагнетик намагничивается до насыщения, при этом он состоит из одного домена с намагниченностью насыщения JS, направленной вдоль внешнего поля H. Типичная зависимость намагниченности от напряженности магнитного поля в случае гистерезиса


Рис. 1 Рис. 2
В результате многочисленных исследований установлена следующая общая картина процесса намагничивания ферромагнетиков.
В отсутствии внешнего магнитного поля ферромагнетик разбивается на домены таким образом, что его результирующий магнитный момент близок к нулю. При включении внешнего магнитного поля энергии отдельных доменов делаются неодинаковыми: энергия меньше для тех доменов, в которых вектор намагниченности образует с направлением поля острый угол, и больше в том случае, если этот угол тупой. Поэтому возникает процесс смещения границ доменов, при котором объем доменов с меньшей энергией возрастает, а с большей энергией уменьшается. В случае слабых полей эти смещения границ обратимы и точно следуют за изменением внешнего поля. При увеличении поля смещение границ доменов делаются необратимыми. При достаточной величине поля энергетически невыгодные домены исчезают вовсе. Если поле увеличивать еще больше, то возникает новый тип процесса намагничивания, при котором изменяется направление магнитного момента домена. В очень сильном магнитном поле HS магнитные моменты всех доменов устанавливаются параллельно полю. В этом состоянии ферромагнетик имеет наибольший магнитный момент, то есть намагничен до насыщения, следовательно, при дальнейшем увеличении внешнего поля величина намагниченности JS не меняется.
При уменьшении напряженности внешнего магнитного поля до HS значение намагниченности JS не будет меняться, при дальнейшем уменьшении напряженности внешнего магнитного поля значение намагниченности будет уменьшаться сначала за счет изменения направления магнитного момента домена, а затем преимущественно за счет возникновения и роста доменов с магнитным моментом, направленным против поля. Рост доменов обусловлен движением доменных стенок. Это движение происходит скачками из-за наличия в образце дефектов (неоднородностей, примесей и т. п.), на которых доменные стенки задерживаются. Поэтому при уменьшении поля до нуля у образца сохраняется так называемая остаточная намагниченность JR. Образец полностью размагничивается лишь в достаточно сильном поле противоположного направления HK, называемом коэрцитивной силой. При дальнейшем увеличении магнитного поля обратного направления образец вновь намагничивается вдоль поля до насыщения. При циклическом изменении поля графическая зависимость, характеризующая изменение намагниченности образца, образует замкнутую кривую петлю магнитного гистерезиса. Можно построить график зависимости вектора магнитной индукции Вот напряженности внешнего магнитного поля. Очевидно, что вид кривой будет аналогичен кривой намагниченности, то есть при циклическом изменении поля будет иметь вид замкнутой кривой, которая так же носит название петли гистерезиса.
Допустим, что в данной пленочной структуре пермаллой и кобальт первоначально намагничены в одном и том же направлении (состояние с низким сопротивлением). Если к структуре прикладывается противоположное по направлению магнитное поле с напряженностью больше коэрцитивной силы пермаллоя, но меньше коэрцитивной силы кобальта, то достигается состояние с антипараллельными (встречными) ориентациями магнитных моментов, т. е. состояние с высоким сопротивлением. Усовершенствование методики изготовления двух магнитных слоев с различными магнитными свойствами достигается при использовании контакта антиферромагнетика с ферромагнитным слоем (для эффективного «связывания» магнитных моментов ферромагнитного слоя). При соответствующих условиях осаждения и отжига антиферромагнетик и ферромагнетик взаимодействуют, образуя тонкий промежуточный слой из их смеси, т. е. они «связываются » (в том, что касается магнитных свойств) на границе раздела. Связанный ферромагнитный слой перемагничивается при более высоких напряженностях магнитных полей - вплоть до 105 А/м. Такая структура обычно называется искусственным антиферромагнетиком. Когда один из ее ферромагнитных слоев «связывается» своей внешней поверхностью с антиферромагнитным слоем, то образуется структура, очень устойчивая к чрезвычайно высоким полям и температурам, вплоть до температуры Нееля для антиферромагнетика. В результате материал может иметь высокое сопротивление в широком диапазоне внешних магнитных полей. Два магнитных слоя из одного материала, разделенные немагнитным проводящим материалом, могут иметь различные поля перемагничивания, если их геометрические размеры отличаются и лежат в нанометровом диапазоне (сравнимы с размерами магнитных доменов в них). При комнатной температуре магнитосопротивление спиновых вентилей обычно составляет 5-10%, а поле насыщения находится в диапазоне между 800 и 8000 А/м. Высокая чувствительность таких структур к изменению магнитного поля позволила создать на их основе обширное семейство датчиков, считывающих магнитных головок, интегральных элементов памяти. Для теоретического описания эффекта гигантского магнитосопротивления в структурах с протеканием тока перпендикулярно плоскости структуры предложена следующая модель. Перенос спин-поляризованных электронов из ферромагнитного слоя в немагнитный сопровождается накоплением их вблизи границы раздела со вторым ферромагнитным слоем, поскольку не все прибывшие к этой границе электроны могут разместиться в принимающем ферромагнитном электроде. Это приводит к усилению спин -зависимого межфазного рассеяния, которое может быть представлено связанным с границей раздела электрическим сопротивлением. При переносе носителей заряда вдоль границ слоя (в процессе планарного транспорта) этого не происходит, потому что нет значительного переноса заряда через границы раздела. При вычислении поперечного сопротивления слоистой структуры ферромагнетик/немагнитный проводник/ ферромагнетик значения сопротивлений, соответствующих объемному рассеянию и рассеянию на границах раздела, должны быть включены в общее сопротивление. Следует отметить, что в многослойной структуре накопление спинов, индуцированное взаимодействием последовательно расположенных границ раздела, частично взаимно компенсируется. Это делает вычисление общего сопротивления более сложным, чем для простого последовательного соединения резисторов, моделирующих рассеяние на границах раздела и в объеме. Кроме того, вклад в него объемного спин-зависимого рассеяния определяется соотношением между толщиной материала и длиной спиновой релаксации.
Спин-контролируемое туннелирование. Туннелирование электронов между двумя по-разному намагниченными ферромагнитными слоями, разделенными тонким слоем диэлектрика, предполагает зависимость туннельного тока от магнитного поля. Определенная намагниченность ферромагнитных слоев обеспечивается путем их осаждения в магнитном поле. Процесс туннелирования, существенно зависящий от ориентации спинов носителей заряда в электродах, управляется намагниченностью ферромагнитного материала (рис. 3.44). Туннельная структура имеет большое сопротивление, когда намагниченности двух ферромагнитных слоев направлены в разные стороны. Сопротивление структуры значительно уменьшается, когда во внешнем магнитном поле намагниченности слоев становятся направленными в одну сторону, что обычно называют эффектом туннельного магнитосопротивления (tunneling magnetoresistance ejfect). Как и в случае эффекта гигантского магнитосопротивления, это явление часто описывается в терминах магнитосопротивления туннельного перехода.
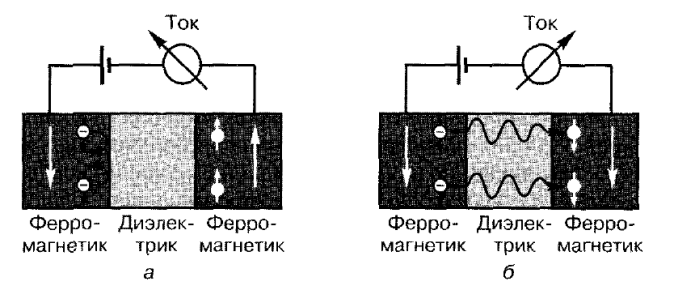
Рис. 3.44.Туннелирование спин-поляризованных электронов через слоистую структуру ферромагнетик/диэлектрик/ферромагнетик: а - антипараллельная намагниченность ферромагнитных слоев - высокое сопротивление; 6 - параллельная намагниченность ферромагнитных слоев - низкое сопротивление
