Осаждение материала активного слоя на резистивную маску с нависающим краем
Использование резистивной маски с нависающим краем позволяет производить осаждение металла с помощью планетарного механизма вращения подложек, а также формировать элементы межсоединений с закругленным профилем, обеспечивающим хорошее покрытие ступенек. Осаждение атомов испаряемого материала под различным углом к подложке приводит к некоторому увеличению размеров элементов микрорисунка, по сравнению с соответствующими размерами окон в маске, т.е. эффекту, противоположному подтравливанию, которое характерно для метода формирования микрорисунка химическим травлением.
С ростом толщины маски от 0.7 до 2.0 мкм наклон дорожек металлизации становится более плавным, однако увеличивается и уход размера элемента под нависающий край. Это обусловливает увеличение расстояния между элементами. Уход размера относительно края маски возрастает с увеличением wmax. Угол между линией АВ, проходящей через край маски и нижний край элемента, и нормалью к подложке (см. рис.4 ) всегда равен wmax, поэтому размер нависающего края маски D1:

а расстояние между краем маски и верхним краем элемента D2 определяется формулой:

где Hm – толщина нависающего края, Hp – толщина пленки от подложки до нависающего края.
Из уравнений _ и _ ширина наклонной части D равна:

т.е. она не зависит от толщины слоя металла.

Рис. 4. Профиль элемента микрорисунка в зависимости от толщины активного слоя при толщине 1,1 мкм
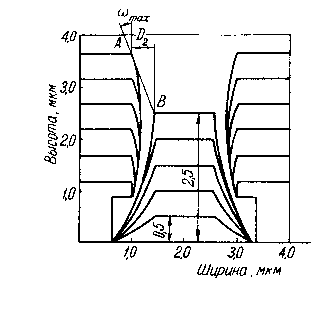
Рис. 5. Определение усредненного угла наклона боковой стенки элемента микрорисунка
Важным параметром многоуровневой системы межсоединений является угол наклона боковой стенки ее элементов Q (рис.5 ), который может быть вычислен по формуле:

Следовательно, профиль формируемых элементов можно контролировать соответствующим подбором входящих в уравнение ( ) величин.
Метод взрывной литографии довольно точно передает размеры резистивной маски, однако при субмикронных размерах начинает сказываться эффект затенения при осаждении материала активного слоя.
В зависимости от размеров маски, можно выделить три типа сечений формируемых элементов (рис.6). Когда размеры окна в маске достаточно велики, профиль элемента состоит из плоской середины и наклонных боковых частей. По мере уменьшения размера окна ширина плоской зоны уменьшается до нуля, тогда как размеры наклонных частей не изменяются. При дальнейшем уменьшении размера окна ширина и толщина элемента;
Минимальный размер элемента Wmin, получаемый в процессе взрывной литографии, определяется переходом к последнему случаю:

Минимальный шаг между элементами Pmin равен:

где Smin – минимальный размер окна резистивной маски у основания.

Рис. 6. Профили элемента микрорисунка в случаях, когда размер окна в резистивной маске больше толщины резистивной маски (1), сравним с ней (2) и меньше ее (3)
Из уравнений следует, что минимальный размер элементов можно уменьшить в соответствии с толщиной резистивной маски и максимальным углом напыления wmax, тогда как минимальный размер окна резистивной маски элементов определяется методом ее формирования.
Удаление маски
Чаще всего резистивную маску формируют из слоя позитивного фоторезиста типа AZ, а удаляют, растворяя в ацетоне, диметилформамиде, изолопропиловом спирте и (или) их смесях, а также в фирменных растворителях резиста, в состав которых входят дихлорбензол, трихлорэтилен, фенол.
Основным достоинством взрывной литографии с однослойной резистивной маской является простота получения микрорисунка с микронными и субмикронными размерами элементов, поскольку линейные размеры их и окон в маске коррелируют
